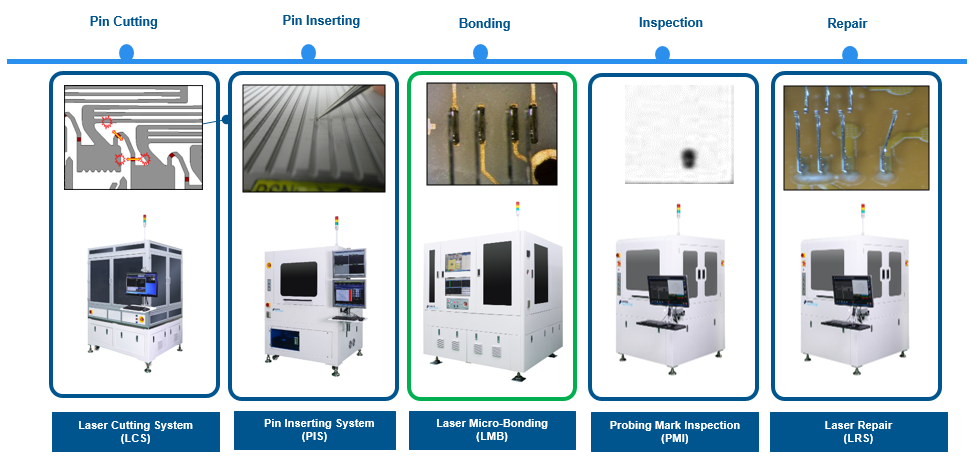
簡介
韓國DAWON NEXVIEW的探針卡自動化生產線雷射設備(PROBE CARD ASSEMBLY AUTOMATION),
從切割探針、排列、焊接、檢查、修補,整個探針卡產線所需設備一應俱全。

焊接流程
此工程分前後兩個工程,用Transfer Gripper把供給到Tray的Probe一個一個移送到Pre-Align Zone是前工程,
用Bonding Gripper在Pre-Align完的Probe沾上焊錫膏,排列在陶瓷基板上後用Laser焊接的後工程。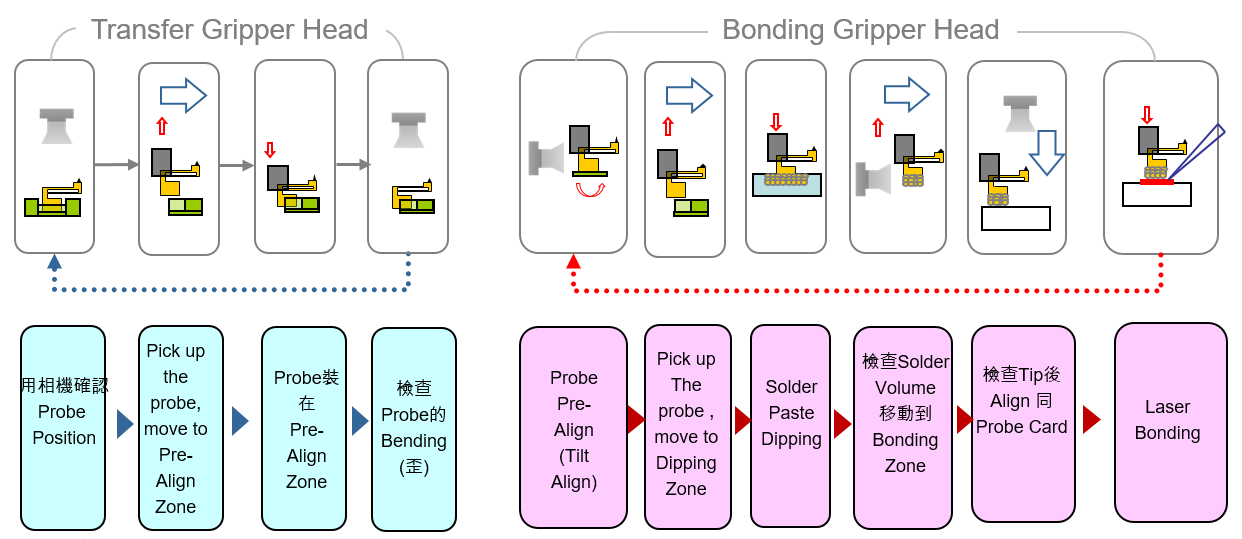
設備結構
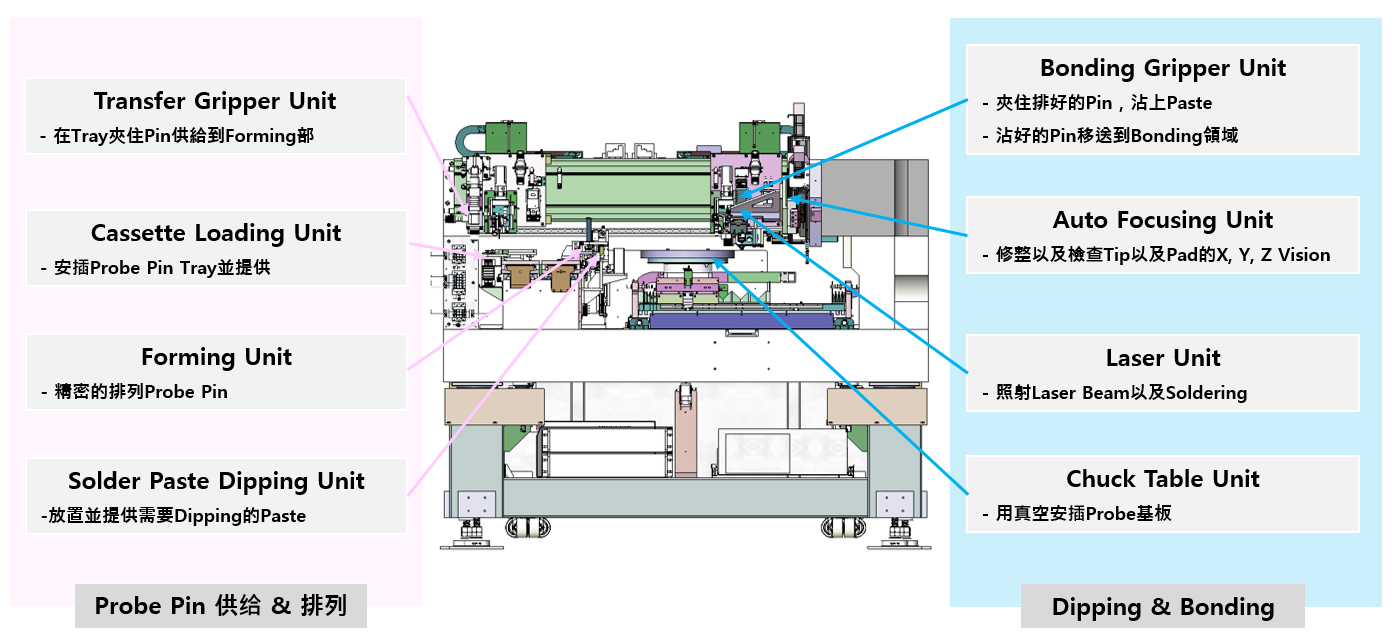
從切割探針、排列、焊接、檢查、修補,整個探針卡產線所需設備一應俱全。
探針卡類型
適用於晶圓等級要求一鍵測試的DRAM, NAND FLASH, CIS用探針卡的製造。
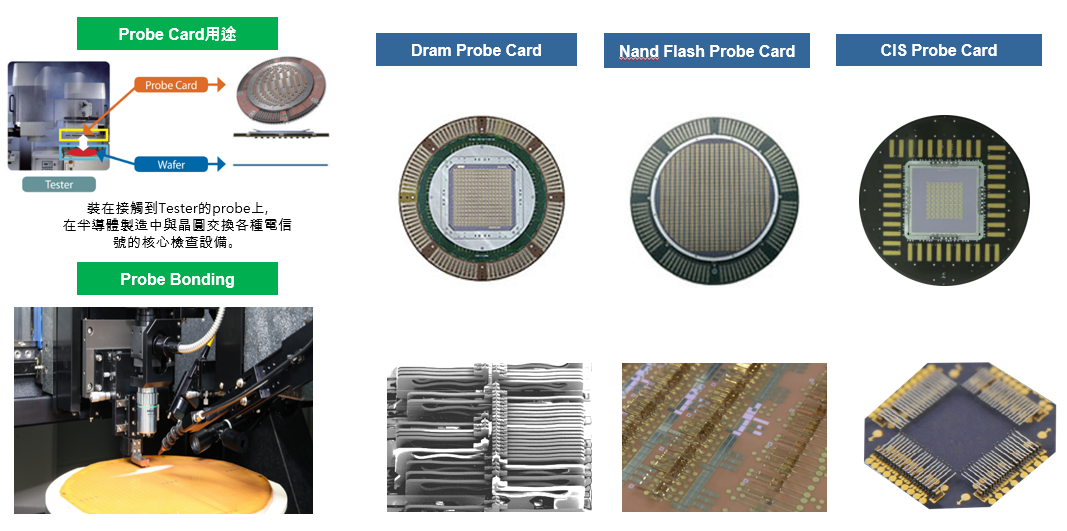
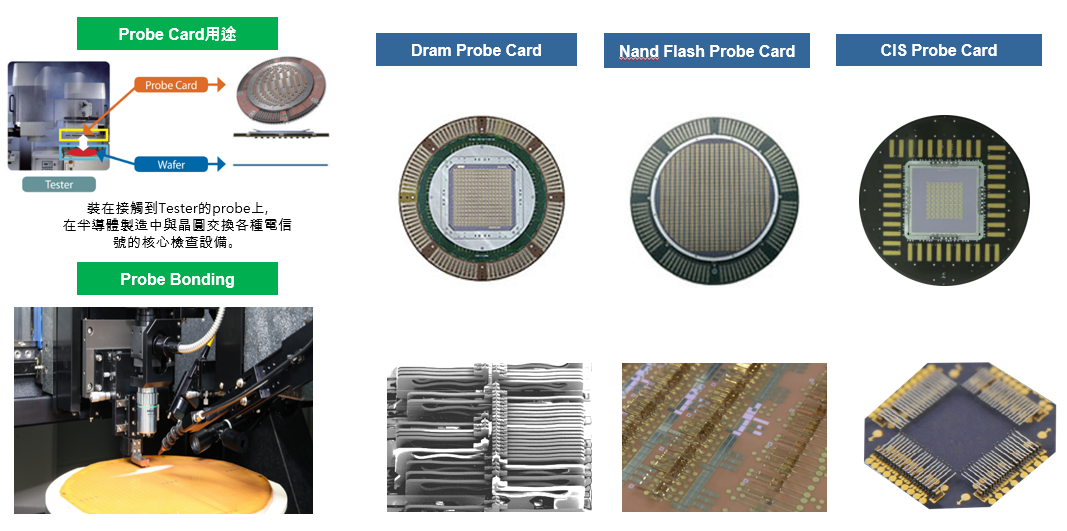
LASER PIN CUTTING SYSTEM
真空吸附在半導體工程例製作的Probe Pin Wafer,用Laser切斷並分離每個Pin的連接部分的設備。


規格
| 搭載UV Nanosecond Pulsed Laser ( Picosecond Option) |
| Cutting Accuracy <±15μm |
| Cutting Time: <0.6sec/point |
| 4”, 6” wafer pin (8” , 12” Option) |
PIN INSERT SYSTEM
切割完的Probe Pin以Dummy狀態或 Wafer狀態提供,用Vision識別位置,一個個自動轉載到Tray的設備。

規格
| 用Vacuum Picker Head與Inserting Gripper Head的高速作工 |
| Tact Time : < 5 sec / pin |
| 裝載High Precision Alignment Vision |
| Wafer狀態可供给 4”, 6” wafer pin (8” , 12” Option) |
LASER MICRO-BONDING SYSTEM
DRAM, NAND Flash, CIS等的晶圓製作之後,
為了選出不良品,在晶圓級進行測試時所需的Prode Card基板上的超精密焊接微小Prode Pin的設備。

為了選出不良品,在晶圓級進行測試時所需的Prode Card基板上的超精密焊接微小Prode Pin的設備。

規格
| Bonding Accuracy ±5um (X, Y), ±8um (Z) within 300mm wafer |
| Less 10 sec/pin tact time @ standard bonding condition |
| 裝載Auto focusing Camera |
| ±1um position repeatability |
| 提供60um pitch bonding |
焊接流程
此工程分前後兩個工程,用Transfer Gripper把供給到Tray的Probe一個一個移送到Pre-Align Zone是前工程,
用Bonding Gripper在Pre-Align完的Probe沾上焊錫膏,排列在陶瓷基板上後用Laser焊接的後工程。
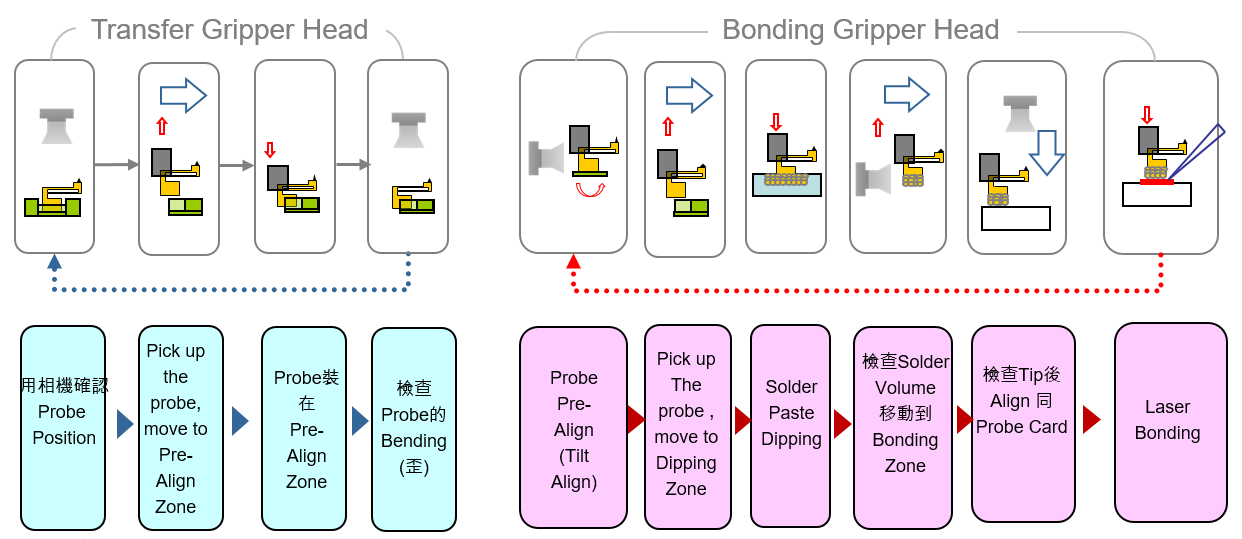
設備結構
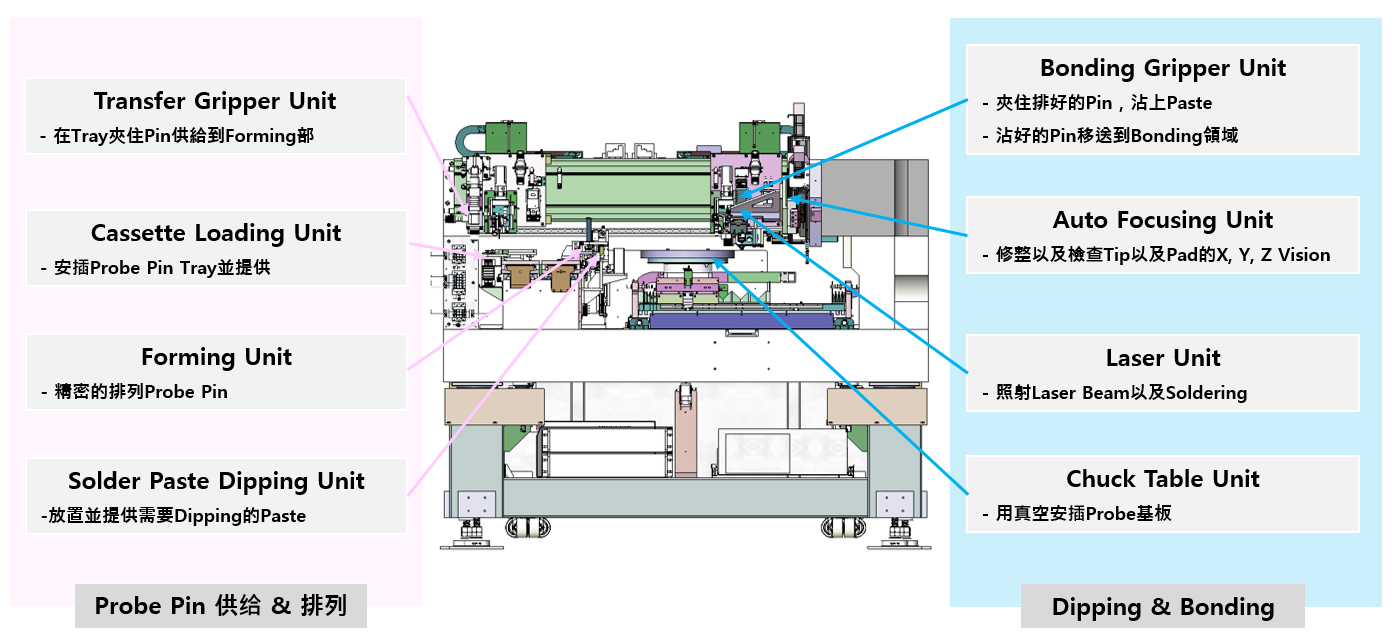
PROBING MARK INSPECTION SYSTEM
為了確認組裝完的Probe Card的最終品質,鏈接Probe Card與晶圓後,
通過Vision檢查鏈接後殘餘的Probing Mark來判定品質的設備。
規格
通過Vision檢查鏈接後殘餘的Probing Mark來判定品質的設備。

規格
| 0.1 sec/mark Fast Inspection Speed |
| Probing Mark X, Y Deviation and Dimension Inspection |
| Provide Various Analysis Report |
| High Resolution 5M B/W CCD Camera (2,464 X 2,056 Pixels) |
| Less 0.1um Pixel Resolution (FOV 2.1 X 1.8 mm) |




